1. Yleiskatsaus monikerroksisesta keraamisesta tekniikasta
Monikerroksiset keraamiset tekniikat ovat perustana nykyaikaiselle elektroniikan valmistukselle. Kolme ensisijaista varianttia hallitsevat kenttää:
· Mlcc (monikerroksinen keraaminen kondensaattori)
· LTCC (matalan lämpötilan kofioitu keraaminen)
· Htcc (korkean lämpötilan kotelotut keraamiset)
Heidän erotuksensa ovat materiaalien valinta, stering lämpötilat, prosessin yksityiskohdat ja
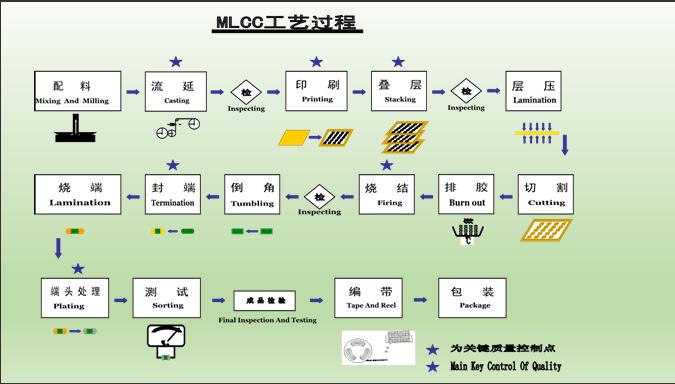
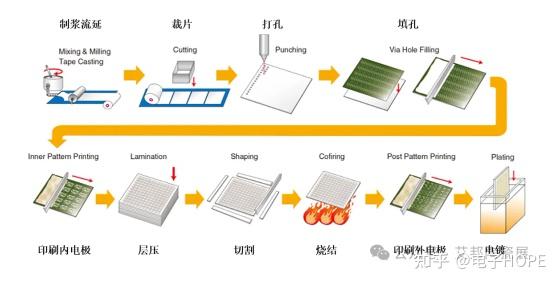

2. Tekniset eritelmät vertailu
|
parametri |
MLCC |
LTCC |
HTCC |
|
Dielektrinen materiaali |
Barium titaani (Batio₃), TiO₂, Cazro₃ |
Lasikeraamiset, keraamiset lasikomposiitti |
Al₂o₃, aln, zro₂ |
|
Metal -elektrodit |
Päivä/cu/ag/pd-ag (sisäinen); AG (Terinaalit) |
AG/AU/Cu/PD-AG (matala sulamiseokset) |
W/mo/mn (korkean sulamisen metallit) |
|
Sintering Temp. |
1100–1350 ° C |
800–950 ° C |
1600–1800 ° C |
|
Key Products |
Kondensaattorit |
Suodattimet, kaksisuuntaiset, RF -substraatit, antennit |
Keraamiset substraatit, voimamoduulit, anturit |
|
Applications |
Kulutuselektroniikka, auto-, televiestintä |
RF/mikroaaltopiiri, 5G -moduulit |
Ilmailu-, suuriteho elektroniikka |
3. Valmistusprosessin virtaus
jaetut ydinvaiheet:
1. Tape -valu: vihreiden keraamisten arkkien muodostaminen (paksuus: 10–100 μm).
2. screen Printing: elektrodikuvioiden tallettaminen (esim. LTCC: n Ag -liitä, NI MLCC: lle).
3. Lamination: kerrosten pinoaminen paineen alla (20–50 MPa).
4. Sintering: ampuminen ohjattuina ilmakehissä (N₂/H₂ MLCC: lle, ilma LTCC/HTCC).
5. termination: ulkoisten elektrodien soveltaminen (esim. MLCC: n pinnoitus).
Kriittiset erot:
· Via Drilling: LTCC/HTCC vaatii laserporaatettua ViaS: tä pystysuuntaisille yhteyksille; MLCC ohittaa tämän vaiheen.
· Sintering ilmakehän:
· Layer count:
4. Suorituskyvyn kompromissit
|
Metric |
MLCC |
LTCC |
HTCC |
|
Capacitance tiheys |
100 μF/cm³ (X7R-luokka) |
N/A (ei-kapacitiivinen keskittyminen) |
N/a |
|
THERMAALINEN KÄYTTÖ |
3–5 w/m · k |
2–3 w/m · k |
20–30 W/m · K (ALN-pohjainen) |
|
CTE -sovitus |
Huono (vs. Si) |
Kohtuullinen |
Erinomainen (al₂o₃ ≈ 7 ppm/° C) |
|
Korkean taajuuden menetys |
Tan Δ <2% (1 MHz) |
Matala insertiohäviö (<0,5 dB @ 10 GHz) |
Vakaa THz -taajuuksille |
5. Nousevat innovaatiot
· Ultra-korkea kerros MLCC: TDK: n 0,4 μm: n kerroksen tekniikka saavuttaa 220 μF 0402 -paketeissa.
· 3d LTCC -integraatio: Kyoceran sulautetut passivit pienentävät RF -moduulin kokoa 60%.
· HTCC ääritayksille: Coorstekin ALN -substraatit kestävät 1000 ° C ilmailu- ja avaruusantureissa.
Conclusion:MLCC-, LTCC- ja HTCC -tekniikat vastaavat erillisiä tarpeita elektroniikkaspektrissä. MLCC hallitsee miniatyrisoituja passiivisia komponentteja, LTCC mahdollistaa kompaktit RF-järjestelmät, kun taas HTCC on erinomainen ankarien ympäristöjen sovelluksissa. Prosessien optimoinnit - materiaalitieteestä arkkitehtuuriin - johtavat jatkuvaa kehitystä 5G-, EVS- ja edistyneissä ilmailujärjestelmissä.
